发布时间:2021-05-19 文章来源:同益光电 浏览次数:14984
PCB板上印刷的喷锡的位置与焊盘居中,无明显的偏移,不可影响SMT元件粘贴与上锡效果;板上印刷喷锡量适中,不能完整的覆盖焊盘,少锡、漏刷; PCB板上印刷喷锡点成形不良,印刷喷锡连锡、喷锡成凹凸不平状,喷锡移位超焊盘三分之一等等。
PCB板上印刷的喷锡的位置与焊盘居中,无明显的偏移,不可影响SMT元件粘贴与上锡效果;板上印刷喷锡量适中,不能完整的覆盖焊盘,少锡、漏刷; PCB板上印刷喷锡点成形不良,印刷喷锡连锡、喷锡成凹凸不平状,喷锡移位超焊盘三分之一等等。
1 目的
为了提升SMT产品焊接的品质,本文件规定了SMT相关元件的焊接标准,使员工操作时有依据可寻,减少误判、错判。
2 范围
本规适用SMT车间所有焊接后的产品。
3 定义
无
4 职责
4.1 工艺部
4.1.1 负责对本文件进行编制、修订等操作;
4.1.2 负责依据本标准对设备相关检验标准进行设定;
4.1.3 负责对操作员和品质人员无法进行判断的可疑品进行复判,并将结果告诉相关人员;
4.2 制造部
4.2.1 负责按照本标准对相关可疑品进行判定;
4.2.2 出现异常时及时报告相关人员;
4.3 品质部
4.3.1 监督员工是否按照本标准进行可疑品判定;
4.3.2 负责对操作员无法进行判断的可疑品进行复判,并将结果告诉操作员;
5 容
5.1 矩形或方形端片式元件
5.1.1 尺寸要求

注1:不违反最小电气间隙。
注2:未作规定的尺寸参数或变量,由设计决定。
注3:润湿明显。
注4:最大填充可偏出焊盘和/或延伸至端帽金属镀层的顶部或侧面;但焊料不能接触到元器件的顶部或侧面。
注5:(C)是从焊料填充最窄处测量。
注6:这些要为组装过程中可能会翻转成窄边放置的片式元器件而制定。
注7:对于某些高频或高振动应用,这些要求可能是不可接受的。
注8:对于宽高比小于1.25:1及有5面端子的元器件可以大于1206
5.1.2 侧面偏移
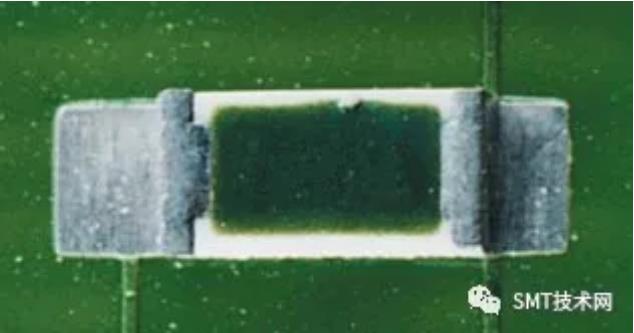
目标:侧面无偏移现象

可接受:侧面偏出(A)小于或等于元器件端子宽度(W)的25%,或焊盘宽度(P)的25%,取两者中的较小者
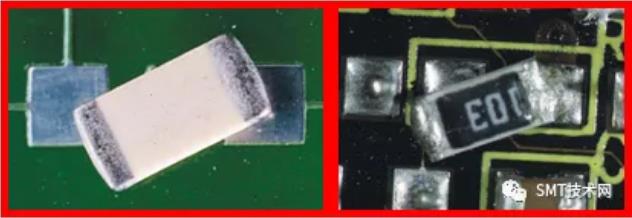
不良:侧面偏出 (A)大于元器件端子宽度 (W)的25%,或焊盘宽度(P)的25%,取两者中的较小者
5.1.3 末端偏出
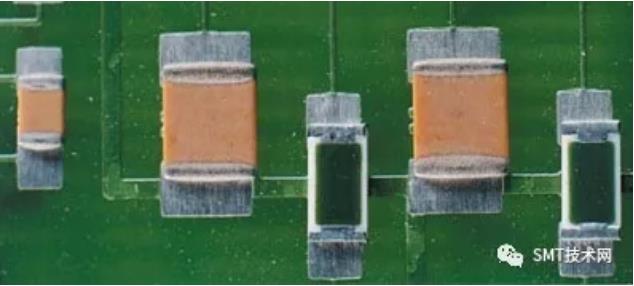
目标:无末端偏出现象

不良:元件末端偏出焊盘
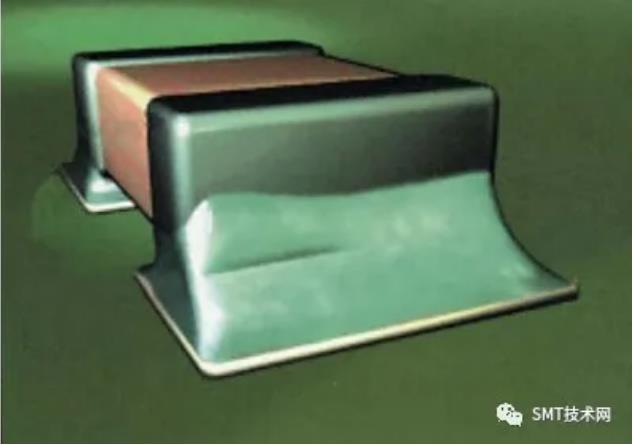
目标:末端连接宽度等于元器件端子宽度或焊盘宽度,取两者中的较小者
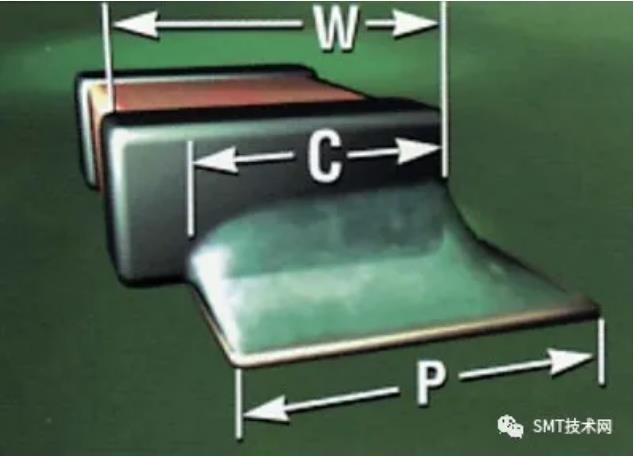
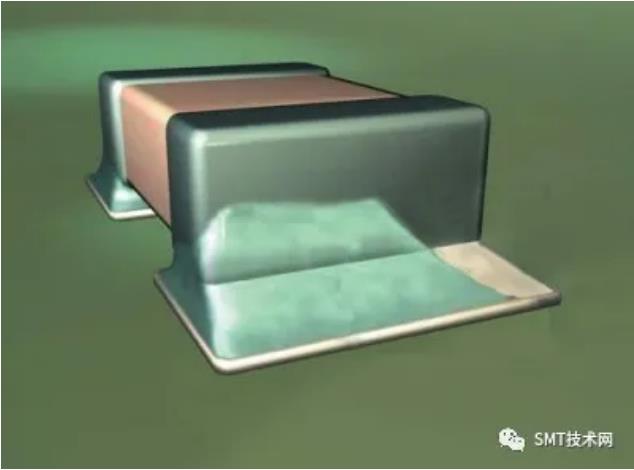
可接受:末端连接宽度(C)至少为元器件端子宽度(W)的75%或焊盘宽度(P)的75%,取两者中的较小者
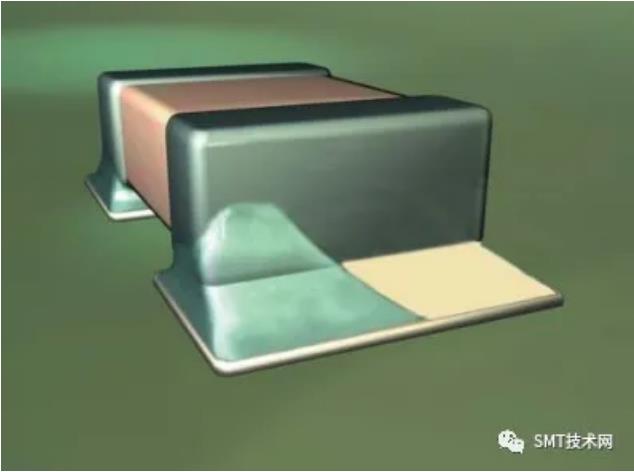
不良:小于可接受末端连接宽度下限
5.1.5 最大爬锡高度
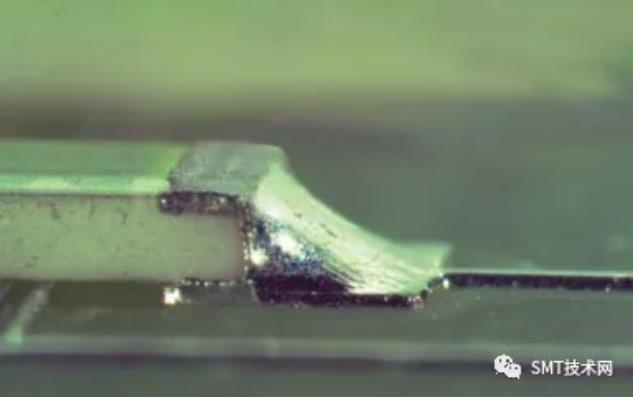
目标:最大爬锡高度为焊料厚度加上元器件端子高度
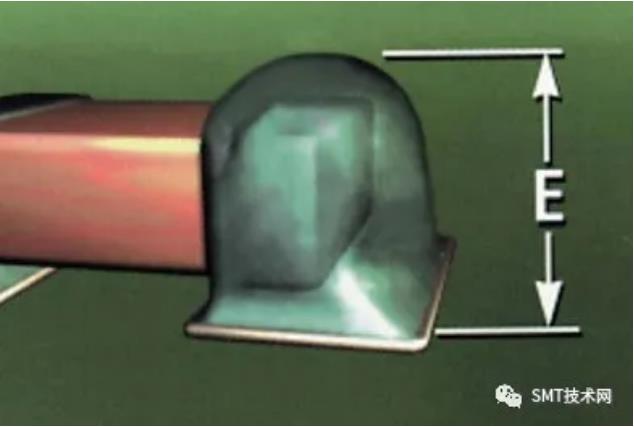
不良:焊料延伸至元器件本体顶部
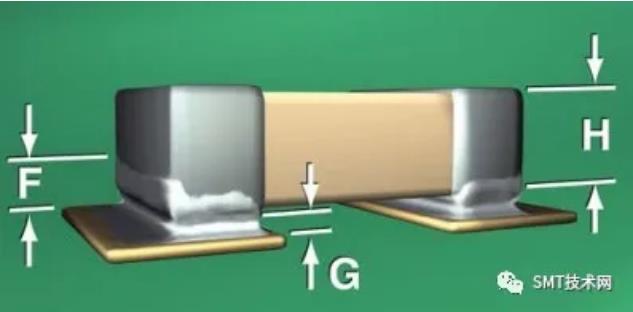
目标:最小爬锡高度(F)为焊料厚度(G)加上端子高度(H)的25%或焊料厚度(G)加上0.5mm[0.02in],取两者中的较小者

不良:小于焊料厚度(G)加上端子高度(H)的25%或焊料厚度(G)加上0.5mm[0.02in],取两者中的较小者
5.1.7 元件末端重叠
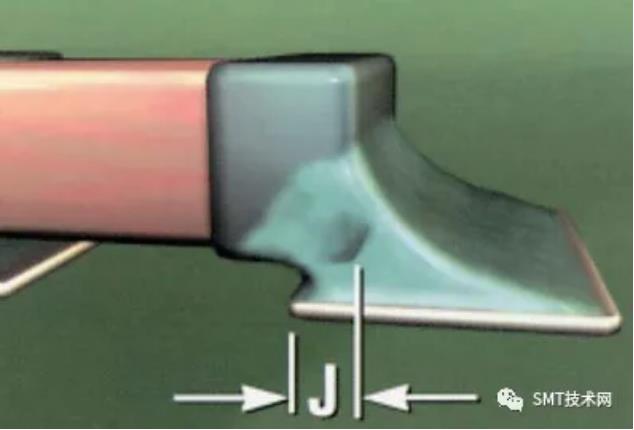
目标:元器件端子和焊盘之间至少有25%的重叠接触
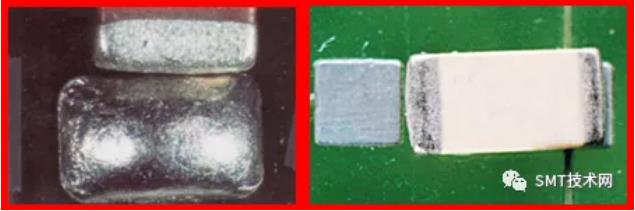
不良:元器件端子和焊盘之间小于25%的重叠接触
5.1.8 侧立
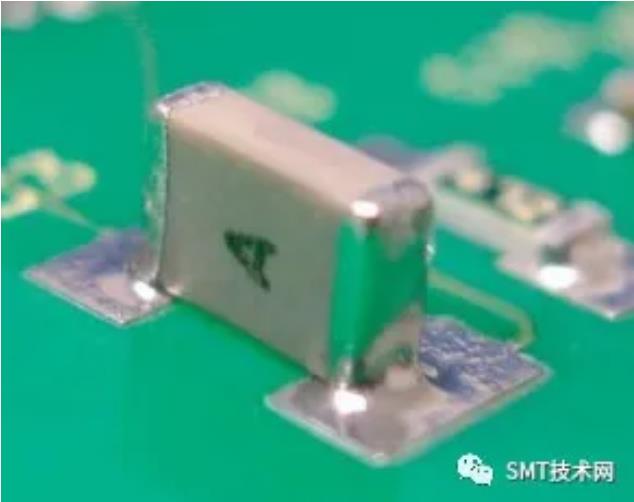
不良:元器件不允许侧立

目标:片式元器件的电气要素面朝上放置

制程警示:片式元器件的电气要素面朝下放置
5.1.10 立碑
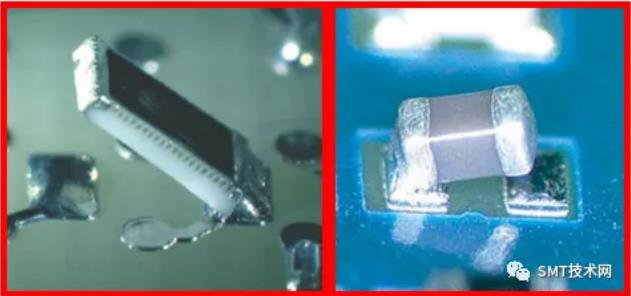
不良:元器件不允许立碑
5.2 圆柱体帽形端⼦
5.2.1 尺寸要求

注1:不违反最小电气间隙。
注2:(C)是从焊料填充的最窄处测量。
注3:未作规定的尺寸或尺寸变量,由设计决定。
注4:润湿明显。
注5:最大填充可偏出焊盘或延伸至元器件端帽的顶部;但焊料不能进一步延伸至元器件本体顶部。
注6:不适用于只有端面端子的元器件
5.2.2 侧面偏移

目标:侧面无偏移现象
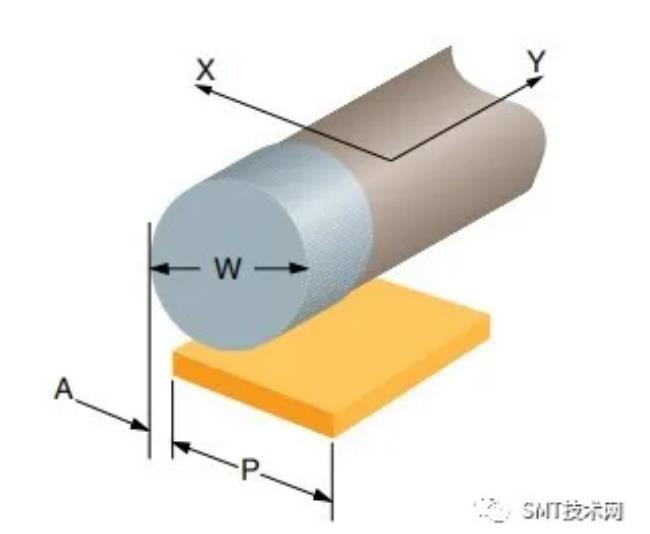
可接受:侧面偏出(A)小于或等于元器件直径(W)的25%,或焊盘宽度(P)的25%,取两者中的较小者

不良:侧面偏出 (A)大于元器件直径(W)的25%,或焊盘宽度(P)的25%,取两者中的较小者
5.2.3 末端偏出
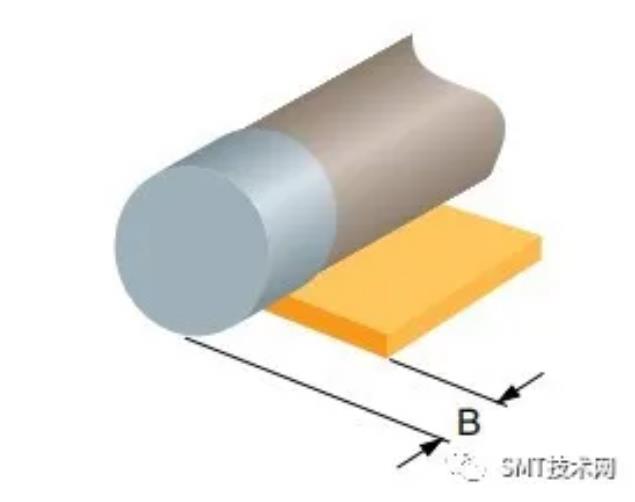
不良:不允许末端偏出
5.2.4 末端连接宽度
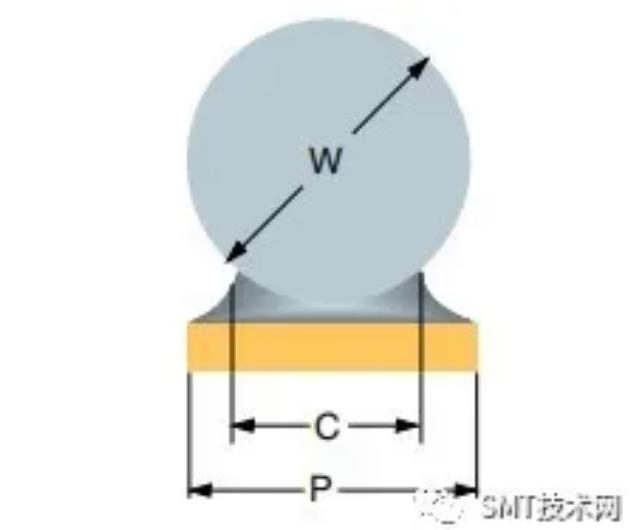
目标:末端连接宽度等于或大于元器件直径(W)或焊盘宽度(P),取两者中的较小者

可接受:末端连接宽度(C)至少为元器件直径(W)的50%,或焊盘宽度(P)的50%,取两者中的较小者

不良:末端连接宽度 (C)小于元器件直径(W)的50%,或焊盘宽度(P)的50%,取两者中的较小者
5.2.5 最大爬锡高度

目标:最大爬锡高度(E)可以偏出焊盘和/或延伸至端子的端帽金属镀层顶部,但不可进一步延伸至元器件本体

不良:焊料填充延伸至元器件本体顶部
5.2.6 最小爬锡高度
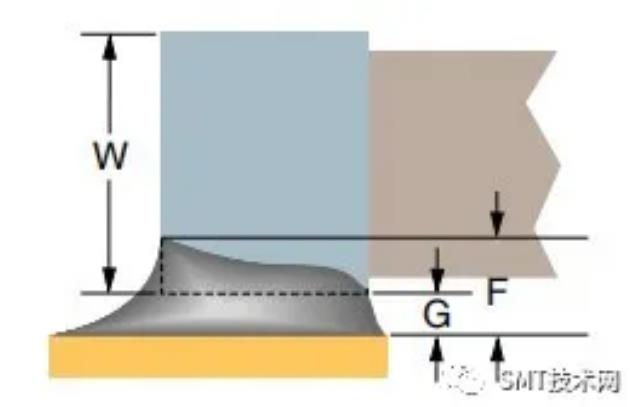
目标:最小爬锡高度(F)为焊料厚度(G)加元器件端帽直径(W)的25%或焊料厚度(G)加1mm[0.04in],取两者中的较小者
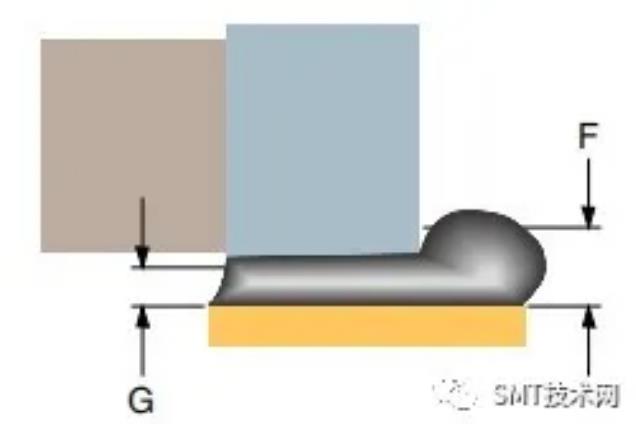
不良:最小爬锡高度(F)小于焊料厚度(G)加元器件端帽直径(W)的25%,或焊料厚度(G)加1mm[0.04in],取两者中的较小者
5.2.7 末端重叠
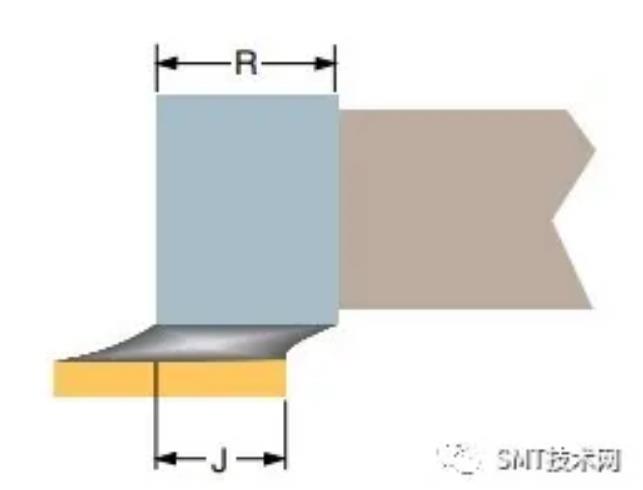
目标:元器件端子与焊盘之间的末端重叠(J)至少为元器件端子长度(R)的75%
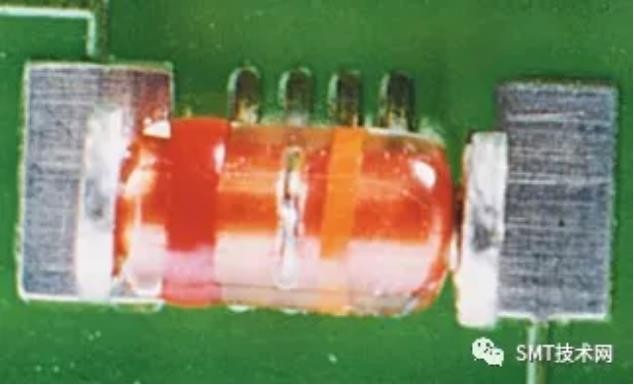
不良:元器件端子与焊盘之间的末端重叠(J)小于元器件端子长度(R)的75%
5.3 扁平鸥翼形引
5.3.1 尺寸要求

注1:不违反最小电气间隙 。
注2:未作规定的尺寸或尺寸变量,由设计决定。
注3:润湿明显。
注4:焊料未接触封装本体或末端密封处。
注5:对于趾部下倾的引线,最小跟部填充高度(F)至少延伸至引线弯曲外弧线的中点。
5.3.2 侧面偏移
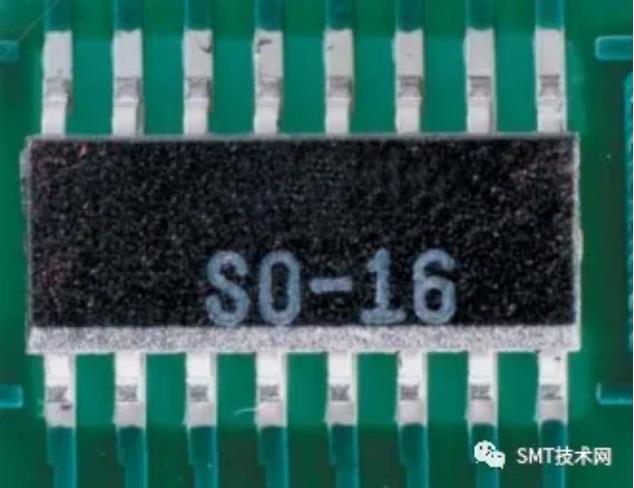
目标:无侧面偏出
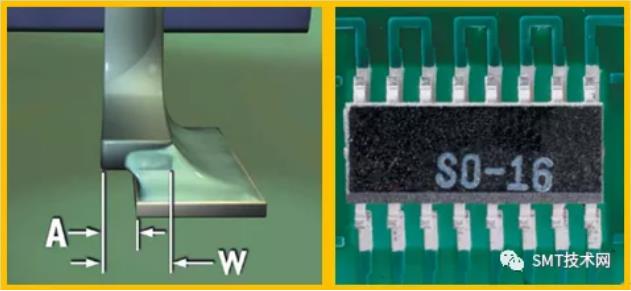
可接受:最大侧面偏出(A)不大于引线宽度(W)的50%或0.5mm[0.02in],取两者中的较小者

不良:侧面偏出 (A)大于引线宽度(W)的25%或0.5mm[0.02in],取两者中的较小者
5.3.3 最⼩末端连接宽度

目标:末端连接宽度等于或大于引脚宽度
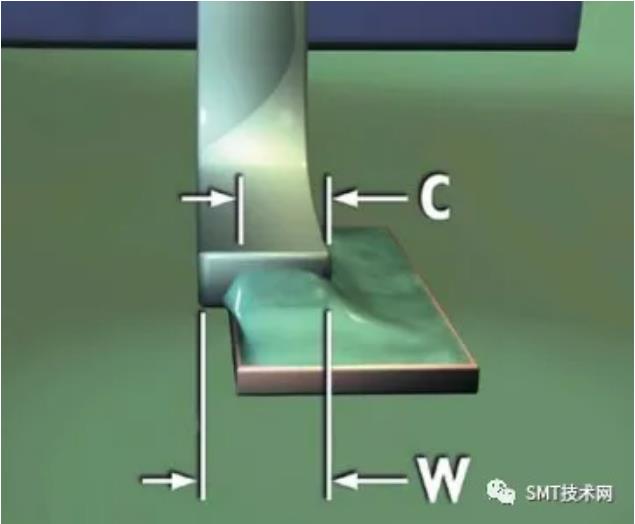
可接受:最小末端连接宽度(C)等于引脚宽度(W)的50%
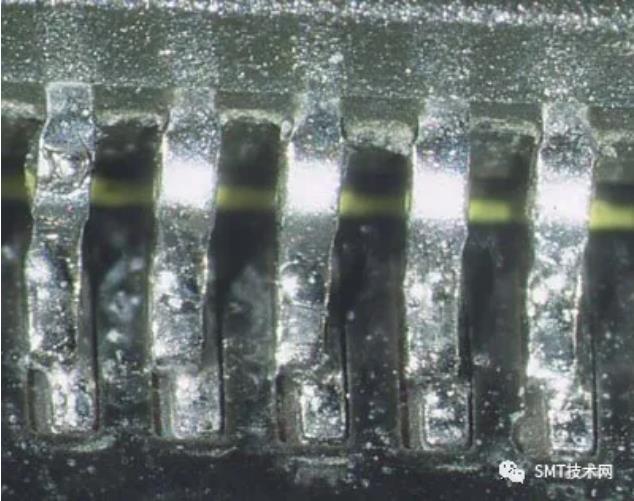
不良:最小末端连接宽度(C)小于引脚宽度(W)的75%
5.3.4 最小侧面连接长度

目标:沿整个引线长度润湿填充明显
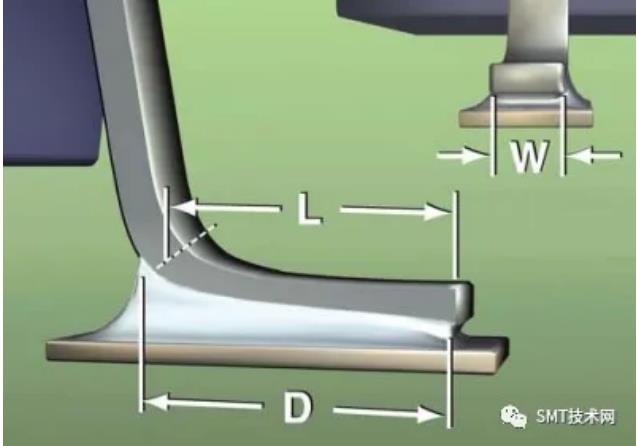
可接受:当脚长(L)大于3倍引线宽度(W)时,最小侧面连接长度(D)等于或大于3倍引线宽(W),
当脚长(L)小于3倍引线宽度(W),最小侧面连接长度(D)等于100%(L)
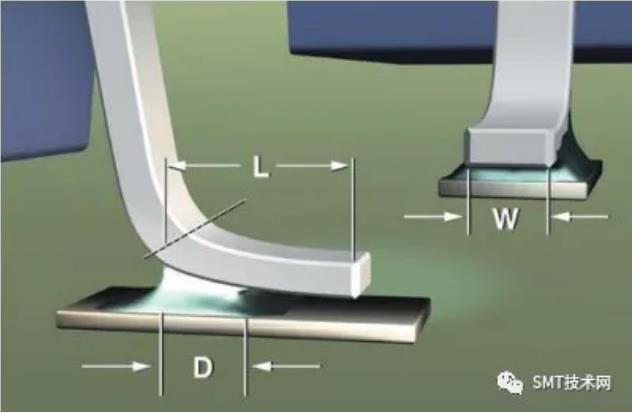
不良:当脚长(L)大于3倍引线宽度(W)时,最小侧面连接长度(D)小于3倍引线宽度(W)或75%的引线长度(L),取两者中的较大者。
当脚长(L)小于3倍引线宽度(W),最小侧面连接长度(D)小于100%(L)
5.3.5 最大根部爬锡高度
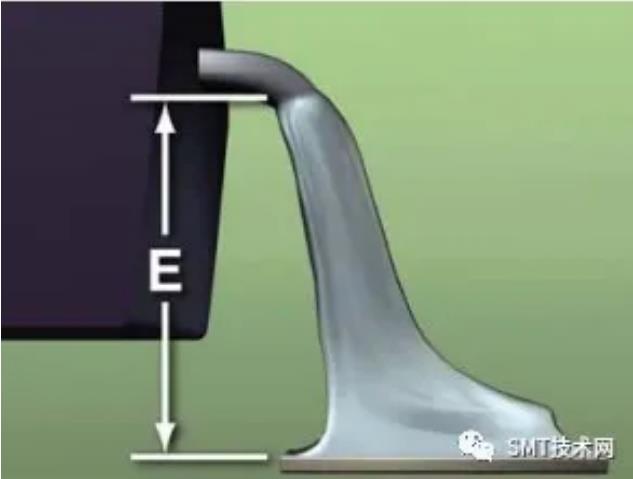
目标:1、跟部爬锡超过引线厚度,但未爬升至引线上方弯曲处。
2、焊料未接触元器件本体

可接受:1、焊料接触塑封SOIC类元器件本体(小外形封装,例如SOT,SOD)
2、焊料未接触陶瓷或金属元器件本体
5.3.6 最小爬锡高度

目标:跟部填充高度(F)大于焊料厚度(G)加引线厚度(T),但未延伸至膝弯半径

可接受:最小跟部填充高度(F)等于焊料厚度(G)加连接侧的引线厚度(T)
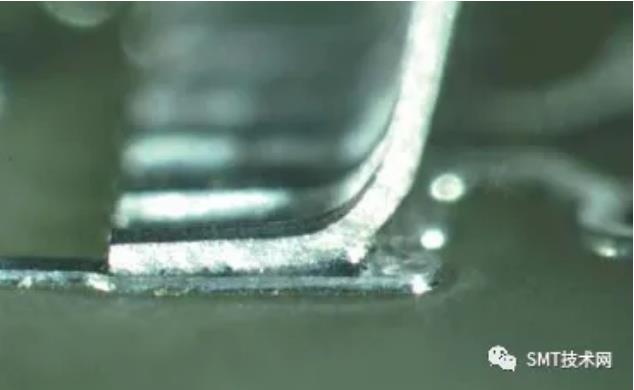
不良:最小跟部填充高度(F)小于焊料厚度(G)加连接侧的引线厚度(T)
5.3.7 共面性

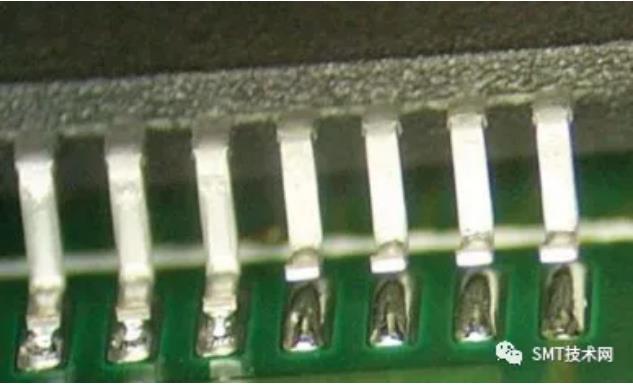
不良:元器件引线不成直线(共面性),妨碍可接受焊点的形成
5.4 弯L形带状引脚、
5.4.1 尺寸要求

注1:不违反最小电气间隙。
注2:未作规定的参数或尺寸变量,由设计决定。
注3:润湿明显。
注4:焊料未接触元器件本体。见8.2.1.
注5:当引线分成两个叉时,每个叉的连接都要满足所有规定的要求。
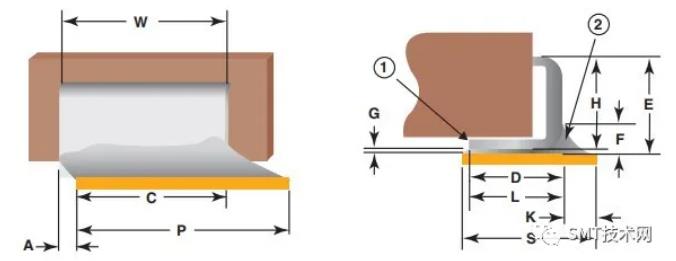
5.4.2 实例

内弯L形带状引线元器件的实例


不良:1、填充高度不足。2、末端连接宽度不足
右图也呈现了元器件侧立妨碍末端连接宽度的形成
5.5 具有底部散热面端子的元件
5.5.1 尺寸要求

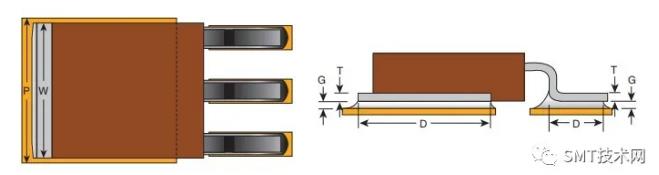
5.5.2 散热面
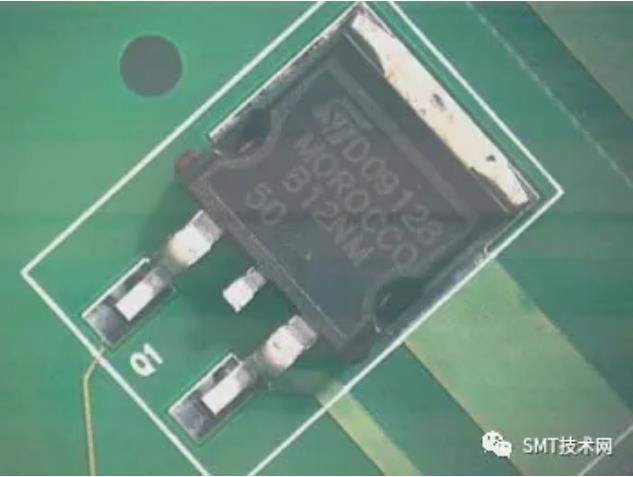
目标:1、散热面无侧面偏出。2、散热面端子边缘100%润湿
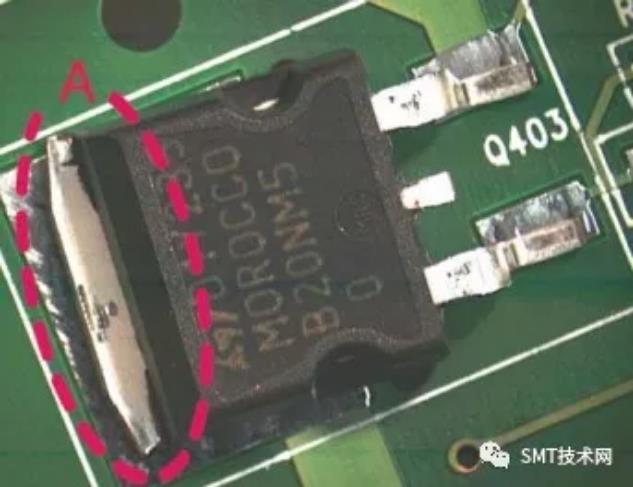
可接受:1、散热面端子的侧面偏出不大于端子宽度的25%
2、散热面末端端子的末端连接宽度与焊盘接触区域100%润湿
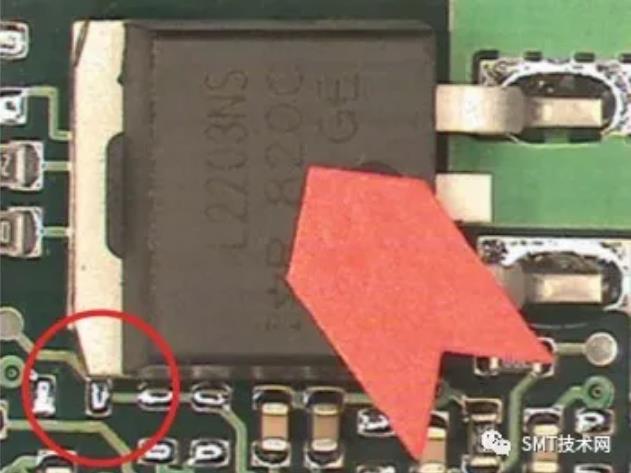
不良:1、散热面端子的侧面偏出大于端子宽度的25%。2、散热面端子的末端偏出焊盘。
3、散热面末端端子的连接宽度与焊盘接触区域的润湿小于100%。4、散热面偏出违反最小电气间隙